
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Receptor SiC ALD
O Susceptor Semicorex SiC ALD oferece inúmeras vantagens em processos ALD, incluindo estabilidade em altas temperaturas, maior uniformidade e qualidade do filme, maior eficiência do processo e maior vida útil do susceptor. Esses benefícios tornam o SiC ALD Susceptor uma ferramenta valiosa para obter filmes finos de alto desempenho em diversas aplicações exigentes.**
Enviar consulta
Benefícios do SemicorexReceptor SiC ALD:
Estabilidade em altas temperaturas:O Susceptor SiC ALD mantém sua integridade estrutural em temperaturas elevadas (até 1600°C), permitindo processos ALD em alta temperatura que resultam em filmes mais densos com propriedades elétricas aprimoradas.
Inércia química:O Susceptor SiC ALD apresenta excelente resistência a uma ampla gama de produtos químicos e precursores usados em ALD, minimizando os riscos de contaminação e garantindo qualidade consistente do filme.
Distribuição uniforme de temperatura:A alta condutividade térmica do Susceptor SiC ALD promove distribuição uniforme de temperatura em toda a superfície do susceptor, levando à deposição uniforme do filme e melhor desempenho do dispositivo.
Baixa desgaseificação:O SiC tem propriedades de baixa liberação de gases, o que significa que libera impurezas mínimas em altas temperaturas. Isto é crucial para manter um ambiente de processamento limpo e evitar a contaminação do filme depositado.
Resistência Plasmática:O SiC demonstra boa resistência ao ataque com plasma, tornando-o compatível com processos ALD aprimorados com plasma (PEALD).
Longa vida útil:A durabilidade e a resistência ao desgaste do Susceptor SiC ALD se traduzem em uma vida útil mais longa para o susceptor, reduzindo a necessidade de substituições frequentes e diminuindo os custos operacionais gerais.
Comparação de ALD e DCV:
A deposição de camada atômica (ALD) e a deposição química de vapor (CVD) são técnicas de deposição de filme fino amplamente utilizadas com características distintas. Compreender suas diferenças é crucial para selecionar o método mais apropriado para uma aplicação específica.

ALD versus DCV
Principais vantagens do ALD:
Controle de espessura e uniformidade excepcionais:Ideal para aplicações que exigem precisão de nível atômico e revestimentos isolantes em geometrias complexas.
Processamento em baixa temperatura:Permite a deposição em substratos sensíveis à temperatura e uma seleção mais ampla de materiais.
Alta qualidade de filme:Resulta em filmes densos, sem furos e com poucas impurezas.
Principais vantagens da DCV:
Maior taxa de deposição:Adequado para aplicações que exigem taxas de deposição mais rápidas e filmes mais espessos.
Custo mais baixo:Mais econômico para deposição em grandes áreas e aplicações menos exigentes.
Versatilidade:Pode depositar uma ampla variedade de materiais, incluindo metais, semicondutores e isolantes.
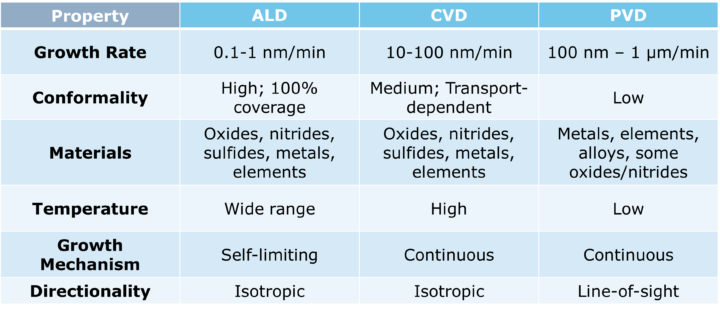
Comparação do método de deposição de filme fino
![]()

![]()
![]()














