
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Luxação em cristais de SiC
O substrato de SiC pode apresentar defeitos microscópicos, como deslocamento do parafuso rosqueado (TSD), deslocamento da borda rosqueada (TED), deslocamento do plano base (BPD) e outros. Esses defeitos são causados por desvios no arranjo dos átomos no nível atômico.
Os cristais de SiC normalmente crescem de uma forma que se estende paralelamente ao eixo c ou em um pequeno ângulo com ele, o que significa que o plano c também é conhecido como plano base. Existem dois tipos principais de discordâncias no cristal. Quando a linha de discordância é perpendicular ao plano de base, o cristal herda as discordâncias do cristal semente para o cristal crescido epitaxial. Essas luxações são conhecidas como luxações penetrantes e podem ser categorizadas em luxações de borda rosqueada (TED) e luxações de parafuso rosqueado (TSD) com base na orientação do vetor de Bernoulli em relação à linha de discordância. As discordâncias, onde tanto as linhas de discordância quanto os vetores de Brönsted estão no plano base, são chamadas de discordâncias do plano base (BPD). Os cristais de SiC também podem ter discordâncias compostas, que são uma combinação das discordâncias acima.
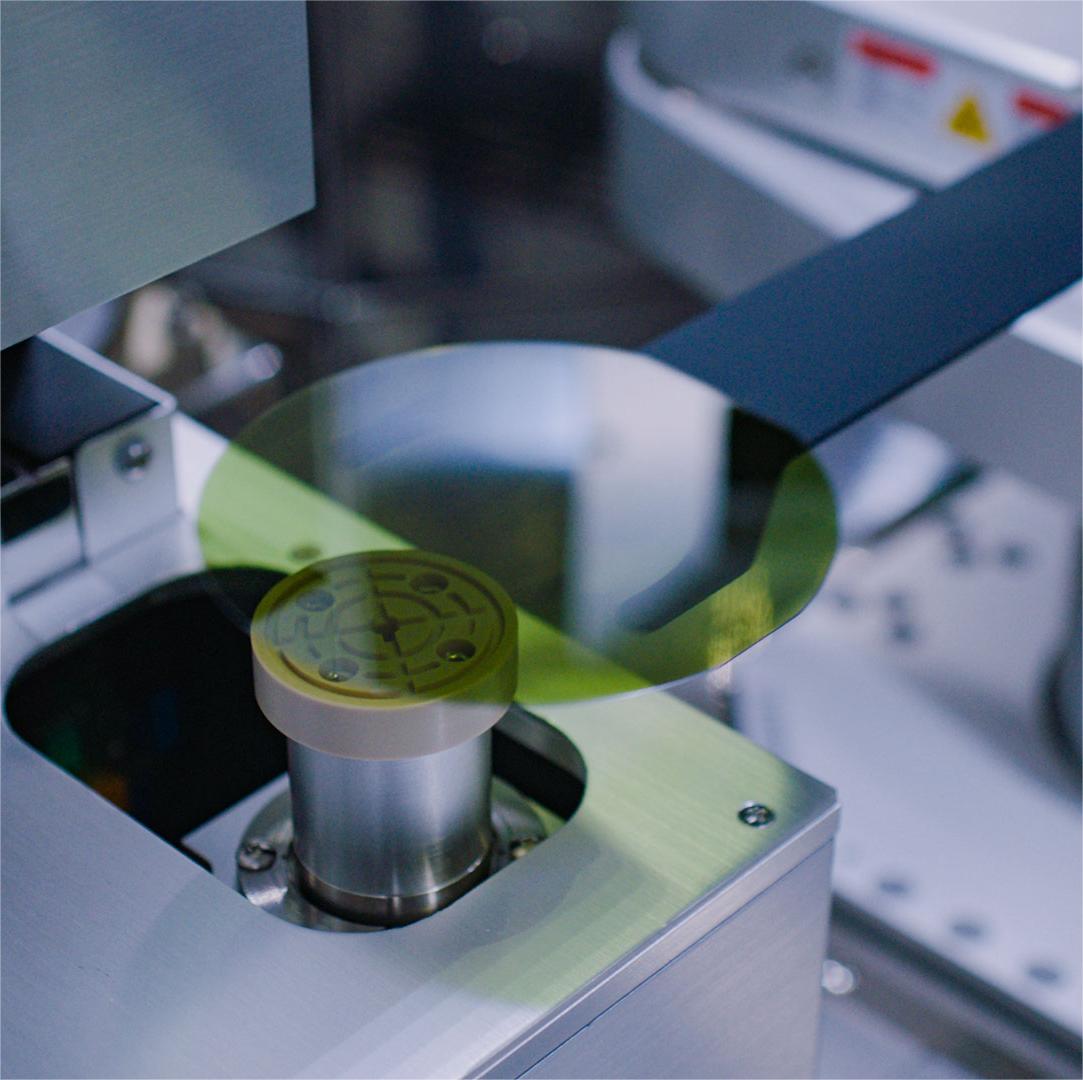
1. TED e TSD
Tanto os deslocamentos roscados (TSDs) quanto os deslocamentos de borda rosqueados (TEDs) correm ao longo do eixo de crescimento [0001] com diferentes vetores Burgers de <0001> e 1/3<11-20>, respectivamente.
Tanto os TSDs quanto os TEDs podem se estender do substrato até a superfície do wafer e produzir pequenas características de superfície semelhantes a poços. Normalmente, a densidade dos TEDs é de cerca de 8.000-10.000 1/cm2, o que é quase 10 vezes maior que a dos TSDs.
Durante o processo de crescimento epitaxial do SiC, o TSD se estende do substrato até a camada epitaxial do TSD estendido, podendo se transformar em outros defeitos no plano do substrato e se propagar ao longo do eixo de crescimento.
It has been shown that during SiC epitaxial growth, TSD is transformed into stacking layer faults (SF) or carrot defects on the substrate plane, while TED in the epitaxial layer is shown to be transformed from BPD inherited from the substrate during epitaxial growth.
2. TPB
As luxações do plano basal (BPDs), que estão localizadas no plano [0001] dos cristais de SiC, têm um vetor de Burgers de 1/3 <11-20>.
Os BPDs raramente aparecem na superfície dos wafers de SiC. Estes estão geralmente concentrados no substrato a uma densidade de 1500 1/cm2, enquanto a sua densidade na camada epitaxial é de apenas cerca de 10 1/cm2.
Entende-se que a densidade dos BPDs diminui com o aumento da espessura do substrato de SiC. Quando examinados por fotoluminescência (PL), os BPDs apresentam características lineares. Durante o processo de crescimento epitaxial do SiC, o BPD estendido pode ser transformado em SF ou TED.
Do exposto, é evidente que defeitos estão presentes no wafer do substrato SiC. Esses defeitos podem ser herdados no crescimento epitaxial de filmes finos, o que pode causar danos fatais ao dispositivo de SiC. Isso pode levar à perda das vantagens do SiC, como alto campo de ruptura, alta tensão reversa e baixa corrente de fuga. Além disso, isto pode reduzir a taxa de qualificação do produto e representar enormes obstáculos à industrialização do SiC devido à redução da fiabilidade.




