
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe na fabricação de chips: uma reportagem profissional
A evolução dos materiais semicondutores
No domínio da tecnologia moderna de semicondutores, o impulso incansável em direção à miniaturização ultrapassou os limites dos materiais tradicionais à base de silício. Para atender às demandas de alto desempenho e baixo consumo de energia, o SiGe (Silicon Germanium) emergiu como um material compósito preferido na fabricação de chips semicondutores devido às suas propriedades físicas e elétricas exclusivas. Este artigo se aprofunda noprocesso de epitaxiade SiGe e seu papel no crescimento epitaxial, aplicações de silício tensas e estruturas Gate-All-Around (GAA).
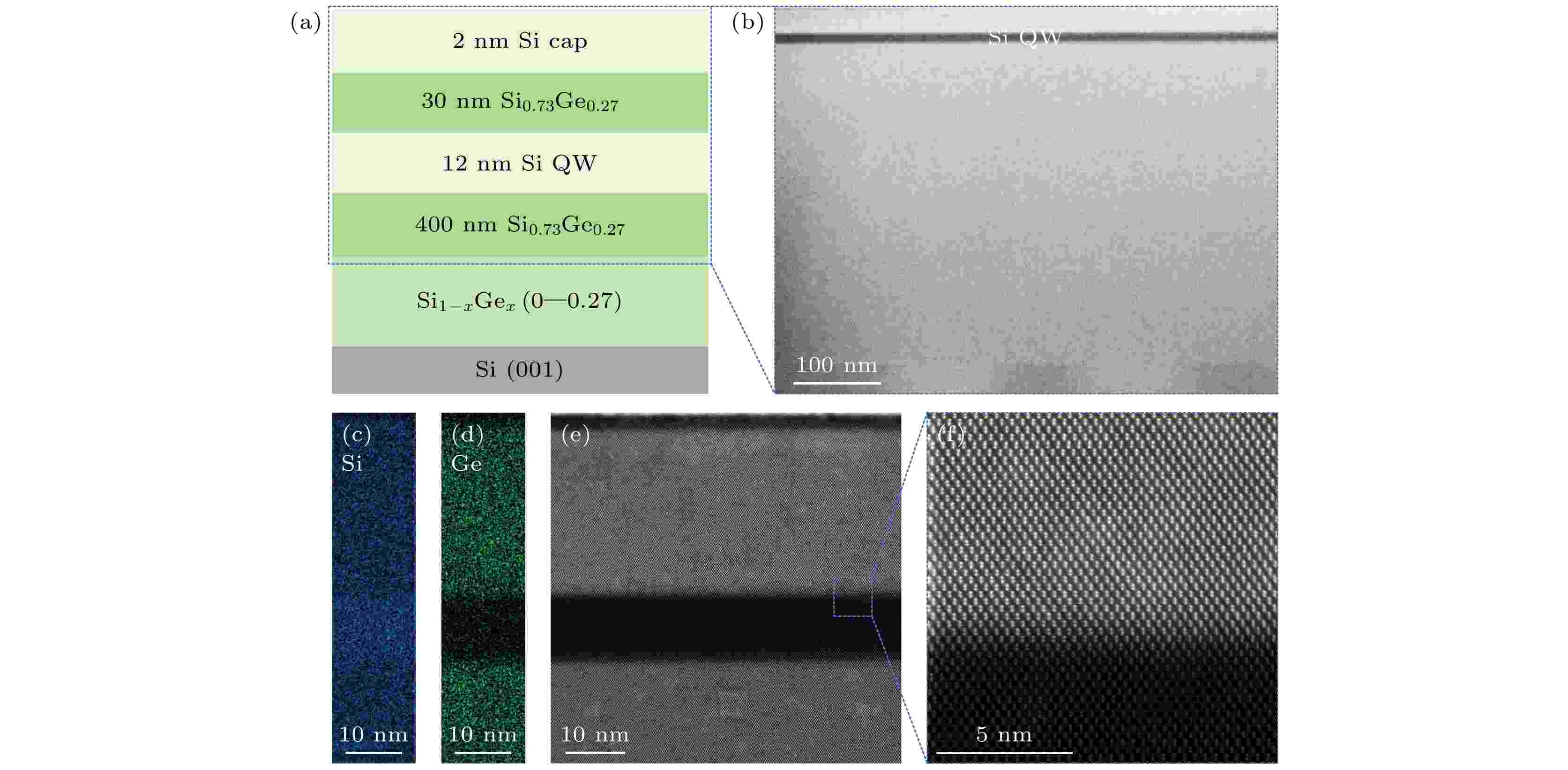
O significado da epitaxia SiGe
1.1 Introdução à Epitaxia na Fabricação de Chips:
Epitaxia, frequentemente abreviada como Epi, refere-se ao crescimento de uma camada de cristal único em um substrato de cristal único com o mesmo arranjo de rede. Esta camada pode serhomoepitaxial (como Si/Si)ou heteroepitaxial (tal como SiGe/Si ou SiC/Si). Vários métodos são empregados para crescimento epitaxial, incluindo Epitaxia de Feixe Molecular (MBE), Deposição de Vapor Químico de Ultra-Alto Vácuo (UHV/CVD), Epitaxia Atmosférica e de Pressão Reduzida (ATM e RP Epi). Este artigo enfoca os processos de epitaxia de silício (Si) e silício-germânio (SiGe) amplamente utilizados na produção de circuitos integrados de semicondutores com silício como material de substrato.
1.2 Vantagens da Epitaxia SiGe:
Incorporando uma certa proporção de germânio (Ge) durante oprocesso de epitaxiaforma uma camada de cristal único SiGe que não apenas reduz a largura do bandgap, mas também aumenta a frequência de corte do transistor (fT). Isso o torna amplamente aplicável em dispositivos de alta frequência para comunicações ópticas e sem fio. Além disso, em processos avançados de circuitos integrados CMOS, a incompatibilidade de rede (cerca de 4%) entre Ge e Si introduz tensão na rede, aumentando a mobilidade de elétrons ou buracos e aumentando assim a corrente de saturação e a velocidade de resposta do dispositivo.
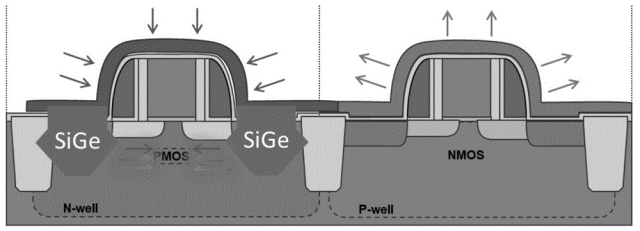
O fluxo abrangente do processo SiGe Epitaxy
2.1 Pré-tratamento:
Os wafers de silício são pré-tratados com base nos resultados desejados do processo, envolvendo principalmente a remoção da camada de óxido natural e das impurezas na superfície do wafer. Para wafers de substrato fortemente dopados, é crucial considerar se a retrovedação é necessária para reduzir a autodopagem durante subsequentescrescimento de epitaxia.
2.2 Gases e Condições de Crescimento:
Gases de silício: Silano (SiH₄), Diclorossilano (DCS, SiH₂Cl₂) e Triclorossilano (TCS, SiHCl₃) são as três fontes de gás de silício mais comumente usadas. O SiH₄ é adequado para processos de epitaxia completa em baixa temperatura, enquanto o TCS, conhecido por sua rápida taxa de crescimento, é amplamente utilizado para a preparação de espessuras espessas.epitaxia de silíciocamadas.
Gás germânio: Germane (GeH₄) é a principal fonte de adição de germânio, usado em conjunto com fontes de silício para formar ligas SiGe.
Epitaxia seletiva: O crescimento seletivo é alcançado ajustando as taxas relativas dedeposição epitaxiale gravação in situ, usando DCS de gás silício contendo cloro. A seletividade se deve ao fato de a adsorção dos átomos de Cl na superfície do silício ser menor que a dos óxidos ou nitretos, facilitando o crescimento epitaxial. SiH₄, sem átomos de Cl e com baixa energia de ativação, é geralmente aplicado apenas em processos de epitaxia completa em baixa temperatura. Outra fonte de silício comumente usada, o TCS, tem baixa pressão de vapor e é líquido à temperatura ambiente, exigindo borbulhamento de H₂ para introduzi-lo na câmara de reação. No entanto, é relativamente barato e frequentemente usado por sua rápida taxa de crescimento (até 5 μm/min) para crescer camadas mais espessas de epitaxia de silício, amplamente aplicadas na produção de wafers de epitaxia de silício.
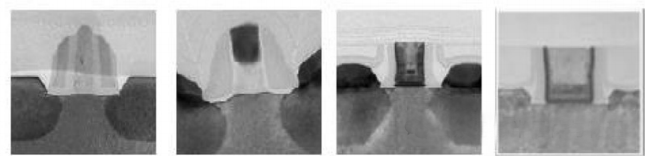
Silício tenso em camadas epitaxiais
Durantecrescimento epitaxial, o Si monocristalino epitaxial é depositado em uma camada relaxada de SiGe. Devido à incompatibilidade de rede entre Si e SiGe, a camada monocristalina de Si é submetida à tensão de tração da camada SiGe subjacente, aumentando significativamente a mobilidade eletrônica nos transistores NMOS. Esta tecnologia não só aumenta a corrente de saturação (Idsat), mas também melhora a velocidade de resposta do dispositivo. Para dispositivos PMOS, as camadas de SiGe são cultivadas epitaxialmente nas regiões de fonte e dreno após a gravação para introduzir tensão compressiva no canal, melhorando a mobilidade do furo e aumentando a corrente de saturação.
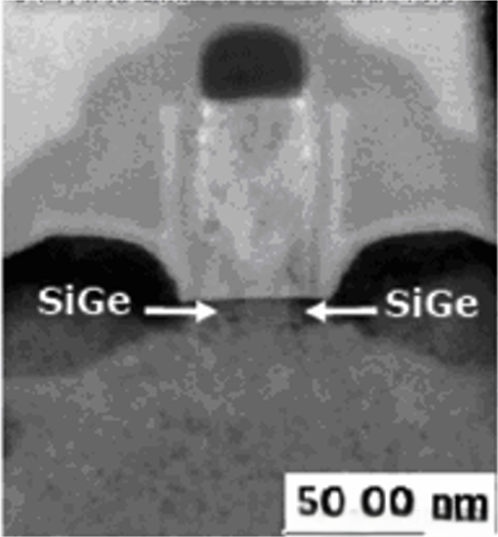
SiGe como camada sacrificial em estruturas GAA
Na fabricação de transistores de nanofios Gate-All-Around (GAA), as camadas SiGe atuam como camadas de sacrifício. Técnicas de gravação anisotrópica de alta seletividade, como a gravação de camada quase atômica (quasi-ALE), permitem a remoção precisa de camadas de SiGe para formar estruturas de nanofios ou nanofolhas.
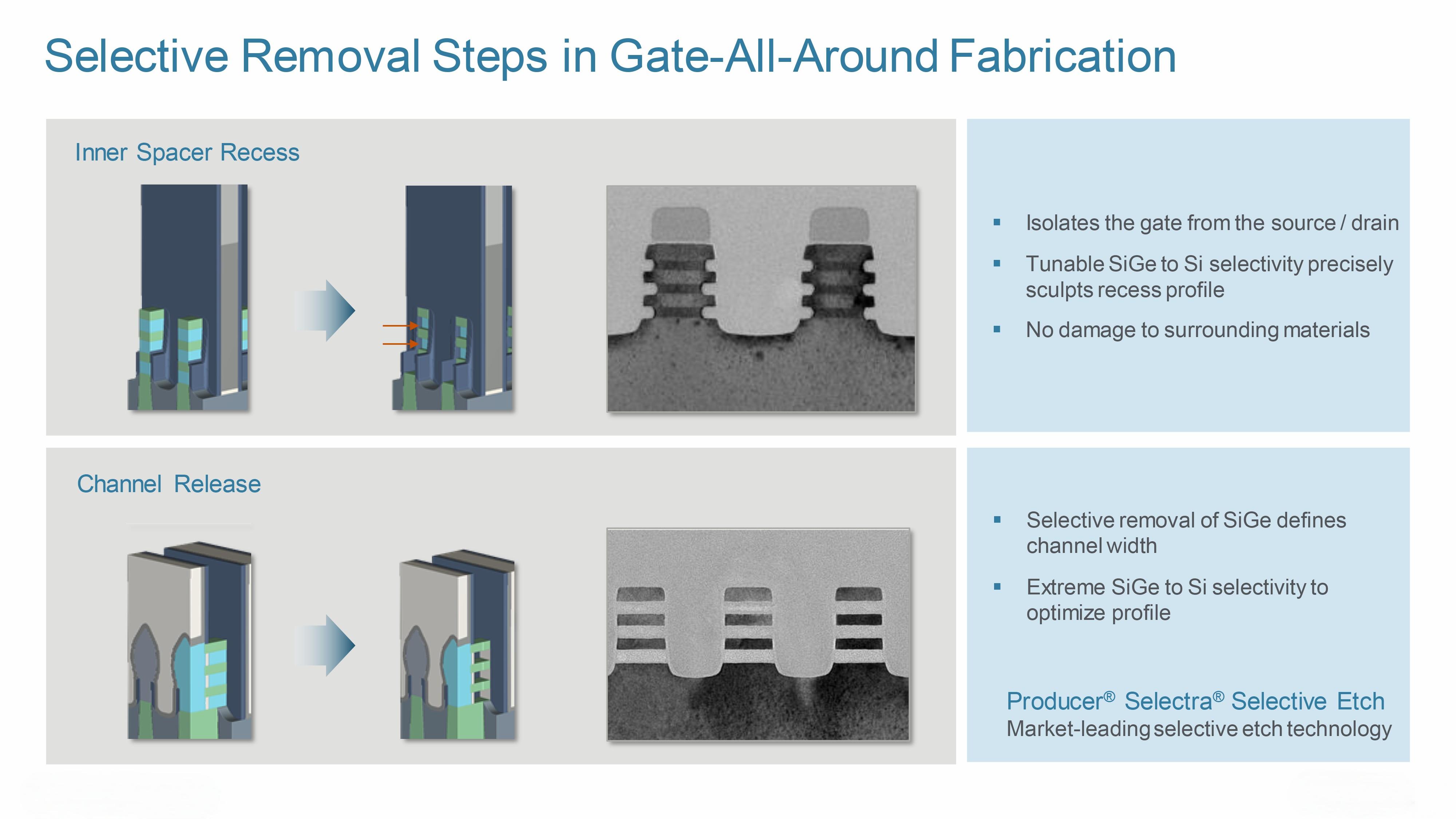
Nós da Semicorex nos especializamos emSoluções de grafite revestidas com SiC/TaCaplicado no crescimento epitaxial de Si na fabricação de semicondutores, se você tiver alguma dúvida ou precisar de detalhes adicionais, não hesite em entrar em contato conosco.
Telefone de contato: +86-13567891907
E-mail: sales@semicorex.com




