
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Métodos convencionais de descolagem
Com o avanço do processamento de semicondutores e a crescente demanda por componentes eletrônicos, a aplicação de wafers ultrafinos (espessura inferior a 100 micrômetros) tornou-se cada vez mais crítica. No entanto, com as reduções contínuas na espessura dos wafers, os wafers são altamente vulneráveis à quebra durante processos subsequentes, como moagem, ataque químico e metalização.
As tecnologias de ligação e desconexão temporária são normalmente aplicadas para garantir o desempenho estável e o rendimento de produção de dispositivos semicondutores. O wafer ultrafino é temporariamente fixado em um substrato rígido e, após o processamento posterior, os dois são separados. Este processo de separação é conhecido como descolamento, que inclui principalmente descolamento térmico, descolamento a laser, descolamento químico e descolamento mecânico.
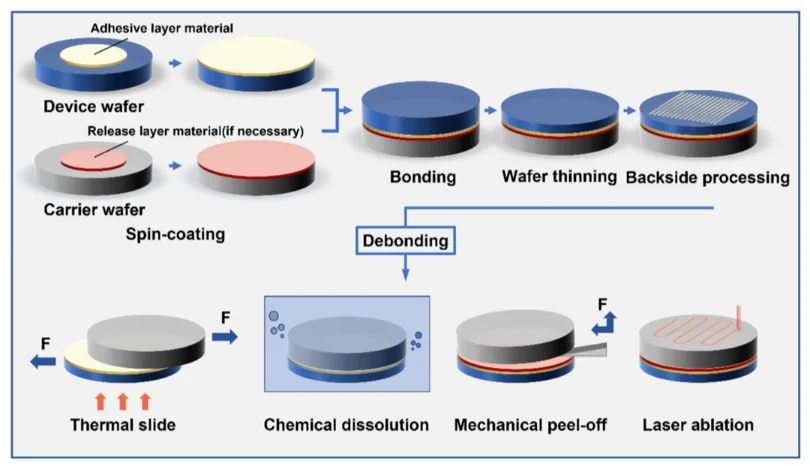
Descolagem Térmica
A descolagem térmica é um método que separa wafers ultrafinos de substratos transportadores por aquecimento para amolecer e decompor o adesivo de ligação, perdendo assim sua adesividade. É dividido principalmente em descolagem por deslizamento térmico e descolagem por decomposição térmica.
A desconexão térmica da lâmina geralmente envolve o aquecimento dos wafers colados até sua temperatura de amolecimento, que varia aproximadamente de 190°C a 220°C. A esta temperatura, o adesivo de ligação perde a sua adesividade e as pastilhas ultrafinas podem ser lentamente empurradas ou retiradas dos substratos transportadores pela força de cisalhamento aplicada por dispositivos comomandris a vácuopara conseguir uma separação suave. Durante a descolagem por decomposição térmica, os wafers colados são aquecidos a uma temperatura mais elevada, causando a decomposição química (cisão da cadeia molecular) do adesivo e perdendo completamente a sua adesão. Como resultado, os wafers colados podem ser destacados naturalmente sem qualquer força mecânica.
Descolagem a laser
A descolagem a laser é um método de descolagem que utiliza irradiação a laser na camada adesiva de wafers colados. A camada adesiva absorve a energia do laser e gera calor, sofrendo assim uma reação fotolítica. Esta abordagem permite a separação de wafers ultrafinos de substratos transportadores à temperatura ambiente ou a temperaturas relativamente baixas.
No entanto, um pré-requisito crucial para a descolagem a laser é que o substrato transportador seja transparente ao comprimento de onda do laser utilizado. Desta forma, a energia do laser pode penetrar com sucesso no substrato transportador e ser efetivamente absorvida pelo material da camada de ligação. Por esta razão, a seleção do comprimento de onda do laser é crítica. Os comprimentos de onda típicos incluem 248 nm e 365 nm, que devem corresponder às características de absorção óptica do material de ligação.
Descolagem Química
A descolagem química consegue separações de wafers colados dissolvendo a camada adesiva de ligação com um solvente químico dedicado. Este processo requer que moléculas de solvente penetrem na camada adesiva para causar inchaço, cisão da cadeia e eventual dissolução, o que permite que wafers ultrafinos e substratos transportadores se separem naturalmente. Conseqüentemente, nenhum equipamento de aquecimento adicional ou força mecânica fornecida pelos mandris a vácuo é necessário; a separação química gera tensão mínima nos wafers.
Neste método, os wafers transportadores são frequentemente pré-perfurados para permitir que o solvente entre em contato total e dissolva a camada de ligação. A espessura do adesivo afeta a eficiência e uniformidade da penetração e dissolução do solvente. Os adesivos de ligação solúveis são principalmente materiais termoplásticos ou à base de poliimida modificada, geralmente aplicados por spin-coating.
Descolagem Mecânica
A descolagem mecânica separa os wafers ultrafinos dos substratos transportadores temporários exclusivamente pela aplicação de força de descascamento mecânico controlada, sem calor, solventes químicos ou lasers. O processo é semelhante ao descascamento da fita, onde o wafer é suavemente “levantado” por meio de operação mecânica de precisão.
Semicorex oferece alta qualidadeMandris de descolamento cerâmicos porosos SIC. Se você tiver alguma dúvida ou precisar de detalhes adicionais, não hesite em entrar em contato conosco.
Telefone de contato # +86-13567891907
E-mail: sales@semicorex.com




